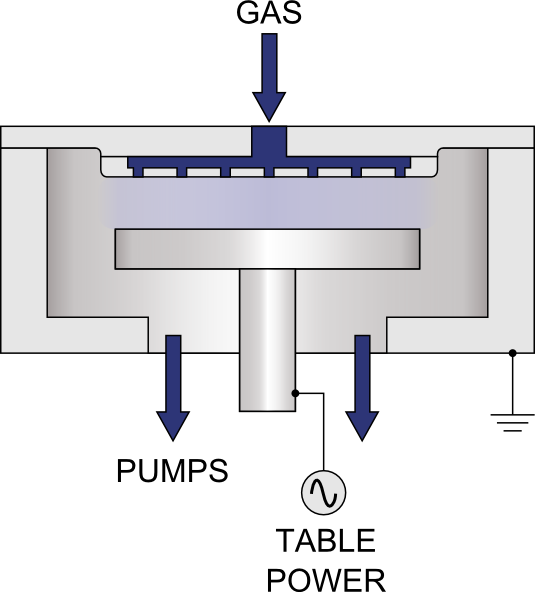
RIE的特点:
可刻蚀的材料范围广泛,包括:
| PlasmaPro 80 |
PlasmaPro 100 | PlasmaPro 800 | ||
| 电极尺寸 | 240mm | 240mm |
460mm | |
| 装载方式 | 开放装载 |
装载锁或盒式 | 开放装载 | |
| 基底 | 最大尺寸240mm |
可选带载具选项的200mm,用于多晶圆或小片 |
最大尺寸460mm | |
| MFC控制的气体管路 | 8或12线气体箱可用 | |||
| 晶圆台温度范围 | -150°C 到 400°C | -150°C 到 400°C | 10°C 到 80°C | |
| He背面冷却选项 | 是 | 是 | 否 | |
| ICP选项 | 是 | 是 | 否 | |
| 聚焦等离子体 | 是 | 否 | 是 | |
 公安机关备案号31010402003473
公安机关备案号31010402003473