离子束技术可以在高真空系统中使用带电离子束来刻蚀。
离子束直接照射于要刻蚀的衬底上。斜角的结构可以使用此系统特有的通过倾斜样品从而改变离子束入射方向的功能来实现。离子束刻蚀有以下两种方式:
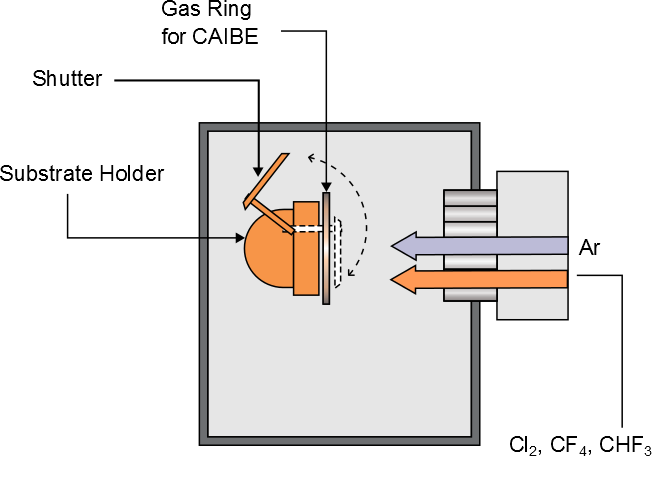
| Ionfab 300 | |
| Ion etch source | 150mm or 300mm |
| Etch area | Up to 200mm |
| Platen speed | Up to 500rpm |
| Platen tilt angle | -90ºC to +75 ºC1 |
| Platen heat | Embedded heaters up to 300ºC |
| Platen cooling | Helium |
 公安机关备案号31010402003473
公安机关备案号31010402003473