Cobra® ICP等离子体源可在低压条件下产生高密度活性物质。基片直流偏压由独立的射频发生器驱动,可根据工艺要求独立控制自由基和离子。
牛津仪器的PlasmaPro 100工艺模块提供了一个最大为200毫米的平台,具备单晶圆和多晶圆批处理的能力。这些工艺模块具有高吞吐量、高精度和出色的均匀性,能够实现干净、光滑的垂直轮廓和刻蚀表面。我们的系统在大批量制造 (HVM) 领域拥有广泛的安装基础,并提供完善的工艺解决方案。
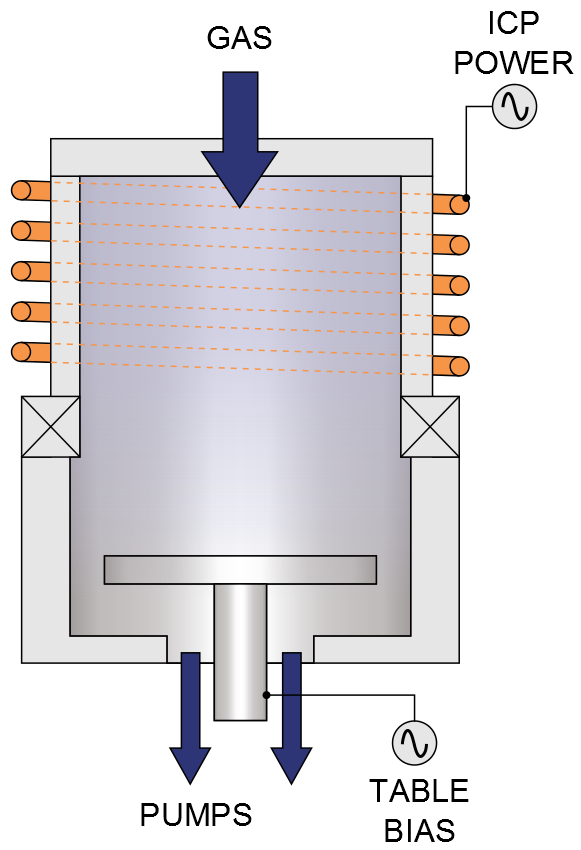
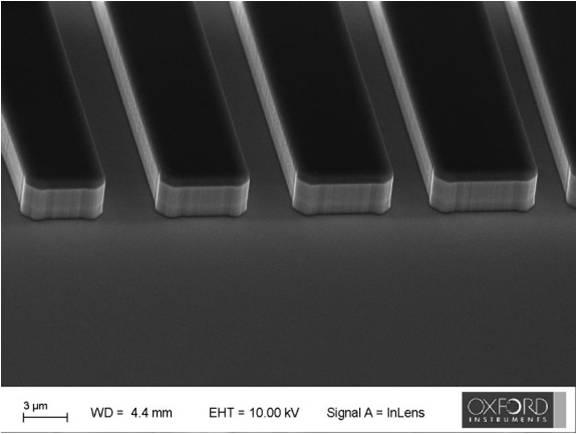
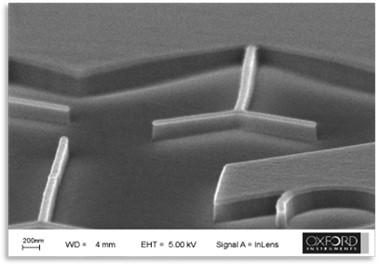
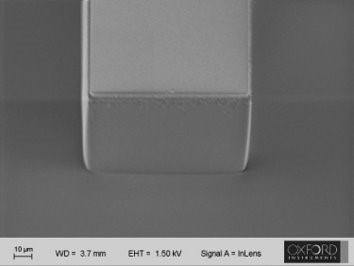
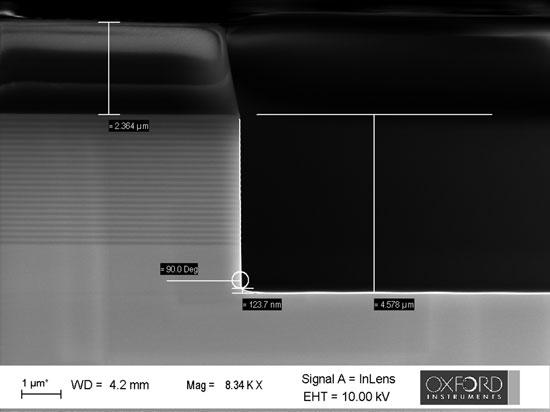
晶圆尺寸:最大可达200mm
ICP源尺寸可选:65mm和300mm
温度范围:从-150°C到400°C
集群:多达5个模块,包括 ALD、PECVD、离子束刻蚀和离子束沉积等技术
我们与格拉斯哥大学的两位研究人员进行了高度信息丰富的交流,他们分享了在该大学的先进James Watt纳米制造中心(JWNC)洁净室中进行的创新项目。
Jharna Paul博士和Valentino Seferai使用牛津仪器PlasmaPro® 100 Cobra ICP RIE系统来制备超导量子比特。
"我们使用牛津仪器PlasmaPro 100 Cobra ICP刻蚀系统,因为您可以有效地控制等离子体、功率、气体传送、室内压力和基板温度。"格拉斯哥大学研究副教授Jharna Paul博士。
"使用PlasmaPro 100 ICP Cobra,我们可以在晶圆上获得非常光滑的表面和侧壁刻蚀,还可以制造更深的结构。甚至我们需要用于紫外LED的硬铝氮化物现在也可以加工成形。"
布伦瑞克工业大学(TU Braunschweig)高级研究小组领导Jana Hartmann博士
"CP系统有效控制刻蚀速率,使工艺更加稳定。"
格拉斯哥大学博士生Valentino Seferai
牛津仪器致力于提供全面、灵活和可靠的全球客户支持。我们在系统的整个生命周期内提供优质服务。
PTIQ是用于PlasmaPro和Ionfab加工设备的最新智能软件解决方案。
● 灵敏的系统控制水平
● 优化系统和工艺性能
● 提供不同级别的软件以满足您的需求
● 全新的直观布局和设计
了解更多RIE模块提供各向异性干法刻蚀,适用于各种工艺。
ICP CVD工艺模块旨在利用低沉积压力和温度下的高密度等离子体,在室温到400°C的温度范围内生产高质量薄膜。
PECVD工艺模块专门设计用于生产具有优越均匀性和高速率的薄膜,并能够控制薄膜特性,如折射率、应力、电特性和湿化学刻蚀速率。
气体储存舱(Gas pod):包括额外的气体管路,提供更大的灵活性。
Logviewer软件:数据记录软件,允许实时绘图和运行后的分析。
光学终点检测器:用于实现最佳工艺结果的重要工具。
软泵(Soft pump):用于缓慢地抽真空室。
分子泵(Turbomolecular vacuum pump):提供卓越的抽真空速度和更高的吞吐量
X20控制系统:提供未来的、灵活的、可靠的工具,具有增强的系统智能。
Advanced Energy Paramount发生器:提供更高的可靠性和更稳定的等离子体。
自动压力控制:可确保非常快速和准确的压力控制。
双CM(电容式)压力表切换:通过单一的压力控制阀,提供利用两个不同范围电容式压力计的能力。
LN2自动切换装置:实现冷却液自动在液氮(LN2)和冷却器流体之间的切换。
TEOS液位传感:使用超声波液位传感器安装在TEOS罐上实现液位传感。
宽温度范围电极:通过重要的设计改进,以提高工艺性能。
 公安机关备案号31010402003473
公安机关备案号31010402003473