ICP RIE刻蚀是一种先进的技术,旨在实现高刻蚀率、高选择性和低损伤加工。由于等离子体可保持在低压状态,因此还能提供出色的剖面控制。
The Cobra® ICP源可产生均匀、高密度的等离子体,并能在低压下运行。基底直流偏压由单独的射频发生器独立控制,可以控制离子能量,从而获得符合特定工艺要求的出色结果。
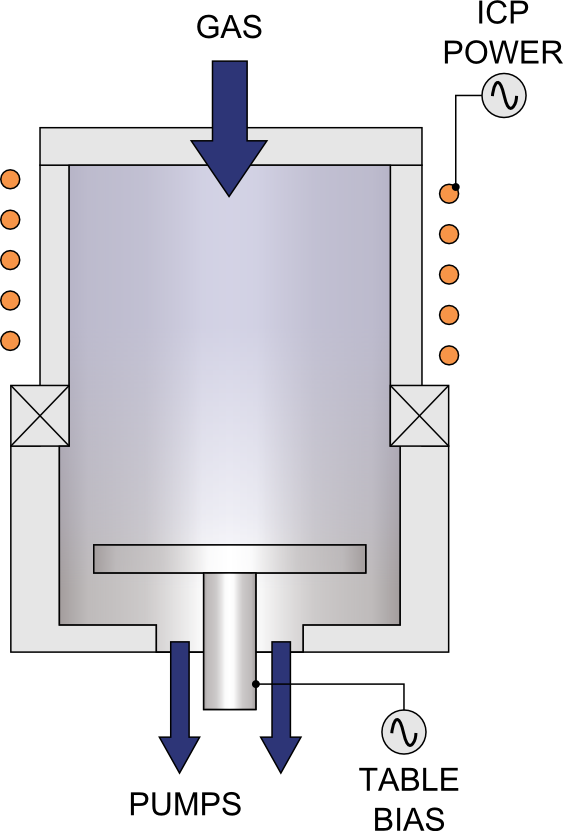
| PlasmaPro 80 |
PlasmaPro 100 | PlasmaPro Polaris | |
| 电极尺寸 | 240mm | ||
| 装载方式 | 开放装载 | 装载锁或盒式 | |
| 晶圆尺寸 | 最大50 mm(2")* | 最大200 mm | |
| MFC控制的气路数量 | 可提供8或12条管路的气箱 | 3-5条密接式气路,可选8-12条外部气路 | 可提供8或12条管路的气箱 |
| 晶圆台温度范围 | -150 ºC至400ºC | ||

ICP刻蚀的InP展现出光滑的侧壁和干净的刻蚀表面
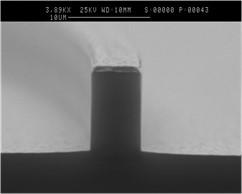
使用Cr掩模对SiO2波导进行 ICP刻蚀
 公安机关备案号31010402003473
公安机关备案号31010402003473